电容耦合等离子体增强化学气相沉积Capacitivitily Coupled Plasma Enhanced Chemical Vapor Deposition - (CCP-CVD)

电容耦合等离子体增强化学气相沉积Capacitivitily Coupled Plasma Enhanced Chemical Vapor Deposition - (CCP-CVD)
北京三和联科技有限公司研发的电容耦合等离子体增强化学气相沉积机台 (CCPCVD) 基于平板式等离子体技术,为等离子体增强化学气相沉积 (PECVD) 技术的一种。CCPCVD采用射频功率源产生等离子体,分解离化反应气体,生成具有活性的基团,这些基团生成薄膜前驱体,并化学吸附到样片表面,生成固态膜晶核,最终以岛状生长成连续薄膜。
三和联电容耦合等离子体增强化学气相沉积主要配置和功能:
1. 支持样品尺寸:12 英寸向下兼容,兼容各种小尺寸样品;
2. RF等离子体功率范围:300 / 500 / 1000 / 1500 W 可选;
3. 分子泵:620 l/s / 1300 l/s 可选,可选配防腐蚀型泵组;
4. 前级泵:机械油泵 / 干泵可选;
5. 控压:0 ~ 1 Torr 可选;也可选择非控压模式配置;
6. 工艺气体:最多可同时配备 12 路工艺气体;
7. 气体量程:根据用户应用需求配合系统设计确定,0 ~ 300 sccm 范围内可选;
8. 样品控温:室温 ~ 400 ℃;
9. 机台冷却:10 ℃;
10. 全自动一键式控制系统;
11. 主要沉积材料:SiO2、SiNx、α-Si;
系列型号:
SHL100/200/300C-CVD
电容耦合等离子体增强化学气相沉积(CVD)设备Layout:
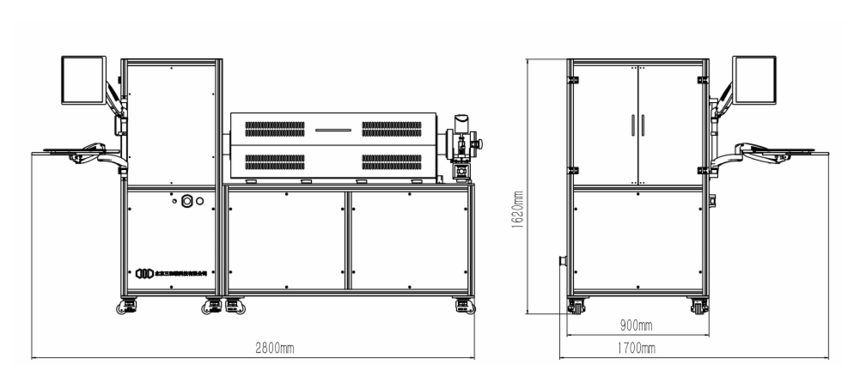
【相关文章】
北京三和联12项独特的团队建设活动,提升团队水平 材料蚀刻:利用广泛使用的酸的腐蚀性的材料加工
薄膜沉积设备国产替代空间广阔,需注重协同、专利与整合 离子束刻蚀机应用方向
北京三和联关于物理气相沉积机台(PVD)研发取得突破性进展 北京三和联科技有限公司国际产品项目启动
用于碳化硅(SiC)刻蚀的电感耦合等离子体(ICP)应用与优化 干法刻蚀ICP(感应耦合等离子体刻蚀机台)蚀刻的基本原理与特点
感应耦合等离子体刻蚀机台在蚀刻中的沟槽效应与挑战 干法蚀刻—工艺参数对 ICP感应耦合等离子体刻蚀机台蚀刻的影响与优化
现代RIE反应离子刻蚀设备构成,精密工程的结晶 设备的“血液”——RIE工艺气体
反应离子刻蚀(RIE)的核心原理——化学与物理的共鸣 反应离子刻蚀(RIE)设备的演进之路
国产刻蚀设备的崛起:替代浪潮背后的动力 中国国产化RIE刻蚀设备的逆袭之路