反应离子刻蚀(RIE)的核心原理——化学与物理的共鸣

反应离子刻蚀(RIE)的核心原理——化学与物理的共鸣
反应离子刻蚀(RIE)设备的核心在于利用低温等离子体在物理轰击和化学反应的双重作用下,对材料进行高度可控的去除。其工作过程精妙而复杂。
北京三和联科技有限公司生产的RIE反应离子刻蚀设备,RF功率源可满足0-300W/500W/1000可调,可根据实际情况自动匹配,最大支持12英寸样片的刻蚀,并且可以支持9种工艺气体,能够满足硅基材料,Ⅲ-Ⅴ材料,Ⅱ-Ⅵ材料,磁性材料,金属材料,有机材料刻蚀,打破国外企业的垄断,在国内各大学,研究所以及Fab厂均有设备在使用中,实现了越来越多刻蚀设备的国产化替代。
反应离子刻蚀RIE的核心原理——化学与物理的共鸣
北京三和联公司是中国国产反应离子刻蚀(RIE)设备厂商之一,多年来坚持自主研发,产品包括炉管式化学气相沉积、电容耦合等离子体增强化学气相沉积及物理气相沉积机台等领域,为我国RIE反应离子刻蚀设备品牌国产化,打破国际垄断助力。
反应离子刻蚀(RIE)设备的核心在于利用低温等离子体在物理轰击和化学反应的双重作用下,对材料进行高度可控的去除。其工作过程精妙而复杂。
1.等离子体生成
设备将特定的工艺气体(如含氟、氯的气体)通入真空反应腔内。在高真空(可达10^-6 Torr甚至更高)环境下,在阴阳两极之间施加高频(RF功率源,13.56MHz)交流电压。强大的电场使气体分子电离、离解,形成包含离子、电子、自由基和中性粒子的高能等离子体
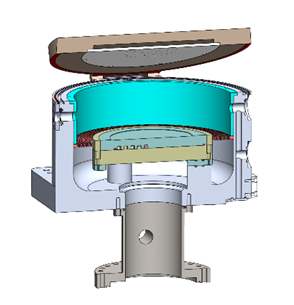

北京三和联设备工艺腔设计图及样品台实物图
离子鞘层与定向轰击: 在电极附近会形成一层数百微米厚的“离子鞘层”(Ion Sheath),其中的离子在鞘层电场的作用下被加速,获得高能量,垂直轰击放置在电极(通常是阴极)上的样品表面。
2.双重刻蚀机制
(a).物理溅射
高速离子的动能撞击直接“敲掉”样品表面的原子或分子。
(b).化学反应
等离子体中产生的化学活性极强的自由基(如氟原子F*、氯原子Cl*)扩散到样品表面,与表层材料发生化学反应,生成挥发性的副产物(如硅刻蚀生成SiF4、SiCl4)。
3.各向异性刻蚀的实现
反应离子刻蚀(RIE)能实现高度垂直刻蚀面的关键,在于离子轰击的方向性。被加速的离子几乎垂直地撞击样品表面(物理溅射方向性强),同时,离子轰击还能打破材料表面的化学键,显著增强该区域的化学反应速率。而在掩膜保护下的侧壁区域,离子难以轰击到,化学反应速率慢得多,从而保证了刻蚀主要向下进行,形成陡直的侧壁。为了实现这种理想状态,需要精确控制真空度、气体流量、射频功率(决定离子能量和密度)等参数。有时还需引入磁场(磁控管)约束电子运动,提高等离子体密度(即MERIE原理)。
北京三和联科技有限公司生产的RIE反应离子刻蚀设备,RF功率源可满足0-300W/500W/1000可调,可根据实际情况自动匹配,最大支持12英寸样片的刻蚀,并且可以支持9种工艺气体,能够满足硅基材料,Ⅲ-Ⅴ材料,Ⅱ-Ⅵ材料,磁性材料,金属材料,有机材料刻蚀,打破国外企业的垄断,在国内各大学,研究所以及Fab厂均有设备在使用中,实现了越来越多刻蚀设备的国产化替代。