反应离子刻蚀(RIE)设备的演进之路

反应离子刻蚀(RIE)设备的演进之路
反应离子刻蚀是通过等离子工艺从表面去除材料。由于传统的蚀刻工艺采用湿化学方法,并使用腐蚀性酸,因此它也被称为干法蚀刻。工艺气体的等离子体将待蚀刻材料的聚集状态从固态转变为气态,然后真空泵抽取气态产物。
北京三和联多年以来专注于等离子体刻蚀机(RIE)国产化,中国离子束刻蚀机(IBE)品牌、市场开拓,自主研发国产刻蚀设备以及干法刻蚀设备国产品牌等方面的研发与生产,在离子刻蚀国产化及扩展中国离子刻蚀设备市场方面发挥着重要作用。
反应离子刻蚀是通过等离子工艺从表面去除材料。由于传统的蚀刻工艺采用湿化学方法,并使用腐蚀性酸,因此它也被称为干法蚀刻。工艺气体的等离子体将待蚀刻材料的聚集状态从固态转变为气态,然后真空泵抽取气态产物。掩模版只能用于蚀刻部分区域或结构。等离子蚀刻只能在低压等离子体中进行,因为需要较长的处理时间才能达到明显的蚀刻效果,并且大多数蚀刻气体只能在低压等离子体中使用。
反应离子刻蚀(RIE)技术诞生的背景
在微电子和半导体制造的世界里,芯片上的微观结构精细程度直接决定了器件性能。要在硅片表面“雕刻”出纳米级的复杂图案,湿法腐蚀因其各向同性的特性难以满足精度要求。反应离子刻蚀(Reactive Ion Etching, RIE)技术应运而生,成为现代芯片制造不可或缺的干法刻蚀核心工艺。今天,我们就来深入了解一下这项精密技术及其核心设备。
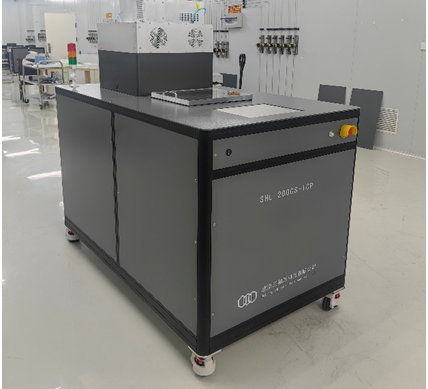
从摸索到成熟:RIE的演进之路
RIE技术的概念萌芽于20世纪70年代初期,随着集成电路对更高集成度和更小线宽的迫切需求而快速发展。早期半导体制造主要依赖湿法刻蚀(使化学溶液),但湿法难以控制刻蚀的方向性(各向异性差),容易导致图形失真。研究人员开始探索利用等离子体在真空环境下进行干法刻蚀。最初的等离子体刻蚀(Plasma Etching)虽然实现了干法,但主要依靠化学反应,各向异性依然不足。为了增强方向性,引入了离子轰击的物理作用,将化学反应与物理溅射相结合,反应离子刻蚀(RIE)技术由此诞生并不断完善。后续发展中,为了获得更高的刻蚀速率、更好的各向异性以及减少对基底损伤,衍生出了诸如磁控增强反应离子刻蚀(MERIE)和电感耦合等离子体反应离子刻蚀(ICP-RIE)等技术变体,进一步扩展了RIE的应用边界和精度极限。
相当长的时间里,全球刻蚀设备市场笼罩在寡头垄断的阴影之下。凭借深厚的技术积累、先发优势和庞大的客户网络,Lam Research、东京电子(TEL)和应用材料(AMAT)构筑了难以撼动的壁垒,三家巨头瓜分了全球九成以上的市场份额。面对巨头环伺与技术封锁,中国半导体设备产业开启了艰辛而卓绝的自主研发征程。刻蚀设备,成为这场国产替代战役中最先取得突破的领域之一,书写了“破壁者”的传奇。
三和联在国产化反应离子刻蚀品牌领域的成就
北京三和联科技有限公司成立于2013年,经过多年自主研发,成功研发出了科研级RIE刻蚀设备,能够满足硅基材料,Ⅲ-Ⅴ材料,Ⅱ-Ⅵ材料,磁性材料,金属材料,有机材料刻蚀,打破国外企业的垄断,在国内各大学,研究所以及Fab厂均有设备在使用中,实现了越来越多刻蚀设备的国产化替代。
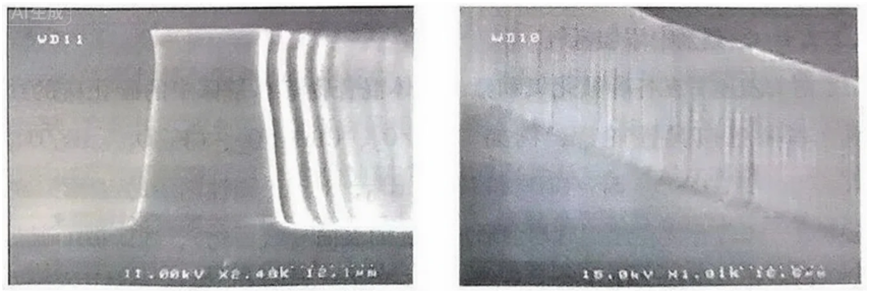
SiO2去层刻蚀,不带孔/带孔结果,芯片失效分析,刻蚀速率:100 nm/min